- 行业新闻
- 碧宇宏光
- 1970-01-01
先进封装基板技术
IC封装基板是半导体封装的重要组成材料,用于搭载芯片,为芯片提供电连接、保护、支撑和散热等。为实现3D-SiP的系统级集成需求,满足未来5G、高性能计算机等高端应用的需求,业界对先进基板提出了提高布线密度、减小线宽线距、减小尺寸与重量,改善热性能的要求。目前,先进封装基板的研究方向主要有工艺改进、精细线路,以及倒装芯片球栅格阵列封装基板(FCBGA)、无芯封装基板、有源无源器件的埋入基板等。
1.FCBGA(Flip Chip Ball Grid Array)
FCBGA是目前图形加速芯片最主要的封装格式。这种封装技术始于20世纪60年代,当时IBM为了大型计算机的组装,而开发出了所谓的C4(Controlled Collapse Chip Connection)技术,随后进一步发展成可以利用熔融凸块的表面张力来支撑芯片的重量及控制凸块的高度,并成为倒装技术的发展方向。
FCBGA的优势有以下几点:第一点是解决了电磁兼容(EMC)与电磁干扰(EMI)问题。采用Wire Bond封装技术的芯片,其信号传递是透过具有一定长度的金属线来进行,这种方法在高频下会产生阻抗效应。但FCBGA用小球代替原先采用的针脚来连接处理器,采用这一封装不仅提供优异的电性效能,同时可以减少组件互连间的损耗及电感,降低电磁干扰的问题,并承受较高的频率。第二点是提高I/O的密度。一般而言,采用WireBond技术的I/O引线都是排列在芯片的四周,但采用FCBGA封装以后,I/O引线可以以阵列的方式排列在芯片的表面,提供更高密度的I/O布局,产生最佳的使用效率,也因为这项优势,倒装技术相较于传统封装形式面积缩小30%至60%。第三点是基于FCBGA 独特的倒装封装形式,芯片的背面可接触到空气,能直接散热。同时基板亦可透过金属层来提高散热效率,或在芯片背部加装金属散热片,更进一步强化芯片散热的能力,大幅提高芯片在高速运行时的稳定性。

2.无芯封装基板
根据是否有芯板,IC封装基板可被分为有芯基板和无芯基板。它使用带有双面铜箔的聚酰亚胺(Polyimide,PI)作为基材,PI膜作为绝缘层,通过加成法实现高密度布线。无芯封装基板厚度仅为传统基板厚度的1/3,厚度降低,不仅使无芯基板更能适应消费类电子产品轻、薄、短、小的趋势,还使它具有更高的信号传输速度、更好的信号完整性、更低的阻抗、更自由的布线设计、以及能够实现更精细的图形和间距等特点。但由于缺乏钢性芯板的机械支撑,使得无芯封装基板强度不足,易于翘曲。如何减少制造和装配过程中的翘曲,成为无芯封装基板研究和生产领域的重要课题。常见的降低无芯封装基板翘曲的方法有:在半固化片中添加玻璃纤维以增加刚度,将基板表层电介质材料更换为刚度更强的半固化片,使用低热膨胀系数电介质材料以降低Cu线路-电介质材料之间热膨胀系数失配导致的翘曲,针对制程开发能够减少翘曲的合适夹具,平衡基板各层覆铜率以减少上下层热膨胀系数失配等。下图展示的是一种无芯封装基板制作方法。
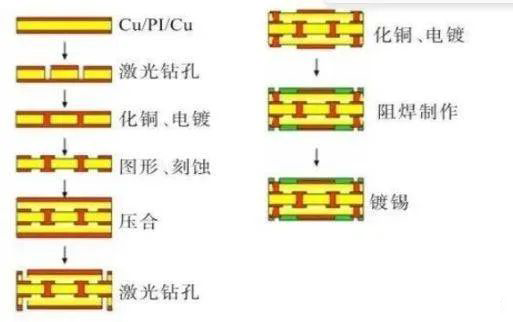
3.埋入式基板
根据埋入的元器件种类,可大致分为无源元件埋入、有源器件埋入以及无源、有源混埋技术和Intel的嵌入式多核心互联桥接(Embedded Multi-die Interconnect Bridge,EMIB)技术。
3.1无源元件埋入基板技术
相比于传统的、将元器件全部焊接至PCB板表面的技术,元器件埋入基板技术有四个优点。第一点是可以增加PCB设计布线的灵活性和自由度,而且可以减少布线和缩短布线的长度,从而大大提高PCB高密度化的程度。第二点是提高PCB组装的高可靠性,通过这样的工艺方法,极为明显地减少PCB板面的焊接点,从而提高了组装板的可靠性,大大地降低由于焊接点引起的故障率的几率。第三点是改善PCB组装件的电气性能,这是因为将无源元件埋入到高密度化PCB中,消除了分立无源元件所需要的连接焊盘、导线和自身的引线焊接后所形成回路。第四点是非常明显节省产品或PCB组装件的成本。
3.2 有源器件埋入基板技术
按照芯片埋入的制程先后顺序,有源器件埋入基板技术可分为芯片先置型(chip-first)埋入技术和芯片后置型(chip-last)埋入技术。芯片先置型埋入技术先将芯片埋入有机绝缘介质中,之后再制作电路图形以实现信号传输和电源供应。芯片后置型埋入技术先制作build-up基板,在制作好的基板上开槽并制作好电路图形,将芯片放置在槽中,实现电气连接后再使用树脂填充芯片与槽体之间的间隙。
与芯片先置技术相比,chip-last技术埋入的芯片位于基板的最上层,可返工且散热更好,埋入芯片后没有其他基板增层工艺步骤,加工良率更高。但是芯片先置技术也有其优势,芯片后置技术埋入芯片只能埋入一层芯片,且埋入芯片的基板表面无法再贴装器件,因此芯片先置技术对基板空间纵向利用率较芯片后置技术更好。
3.3EMIB技术
EMIB是将带有多层导电金属(Back End Of Line,BEOL)互连的超薄硅片埋入有机封装基板的最上层,通过焊球与倒装芯片的连接,以实现两个或多个芯片之间的局部高密度互连。这种埋入式结构可被放置在有机基板的任意位置以实现超高密度局部互连,在远大于典型掩膜版尺寸范围内集成大芯片,使用非常灵活。下图为EMIB技术结构示意图。